
INSIDIX 溫度型變系統
超越傳統 Shadow Moiré:INSIDIX TDM全域投影式熱型變分析系統
●您是否正面臨這些技術難題瓶頸?
-不明原因的變形? 封裝製程中,材料因熱應力導致Warpage難以預測。
-材料匹配難? 晶片與基板間的CTE (熱膨脹係數) 不匹配,導致焊點裂痕、可靠度降低。
-量測干擾多? 傳統接觸式量測容易損傷樣品,且難以模擬動態升溫過程。
-透明材質無法量測? 針對玻璃或鏡面產品,傳統光學法無法克服。
☆ 從晶圓封裝、PCB到SMT,TDM克服傳統Moiré極限。提供完整平坦度與翹曲度解決方案,協助客戶預判產品趨勢&良率。
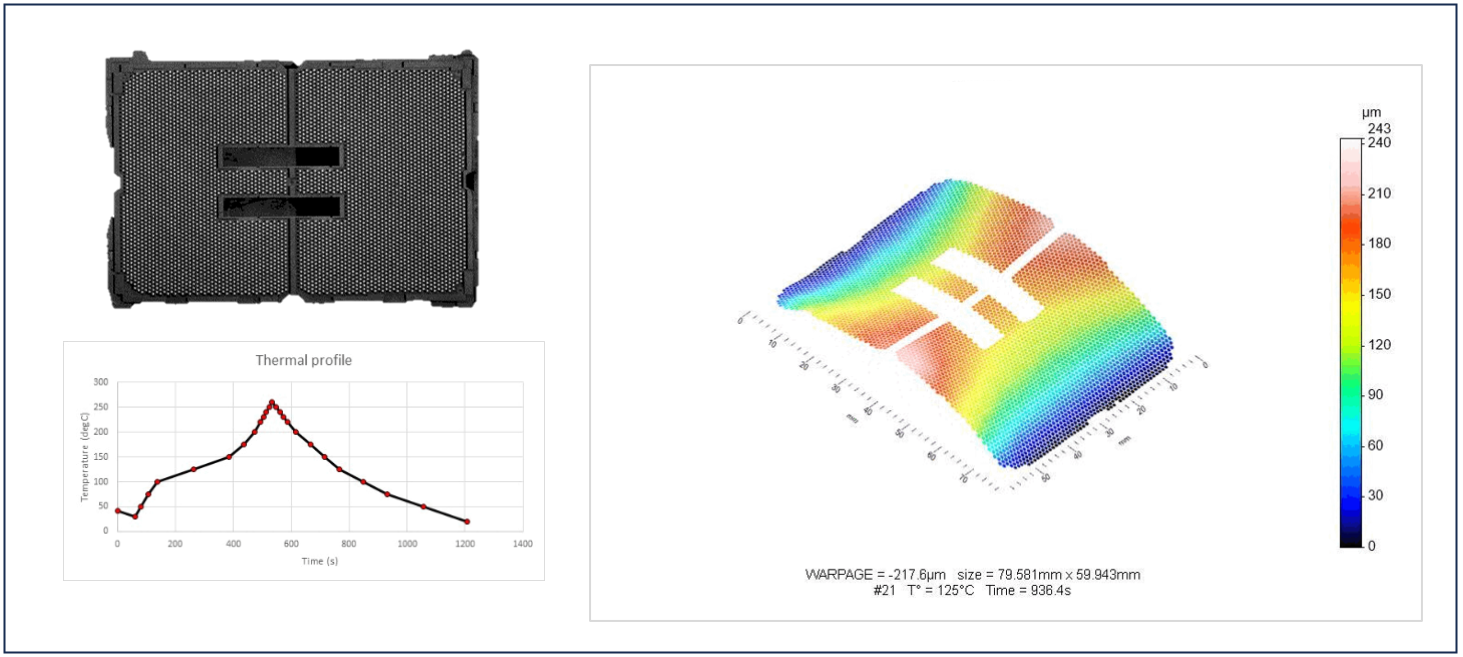
您是否曾在熱型變量測中遇到以下挑戰?
1. 為了量測PCB/鏡面/透明樣品必須噴漆,導致樣品報廢?
2. 擔心實體玻璃光柵受樣品擠壓,導致光柵壽命衰減甚至影響量測數據?
3. 傳統 Shadow Moiré 難以量測錫球、Connector與 PCBA產品?
4. 迴流焊曲線設定繁瑣,耗費大量調整時間,且無法進行負溫量測?
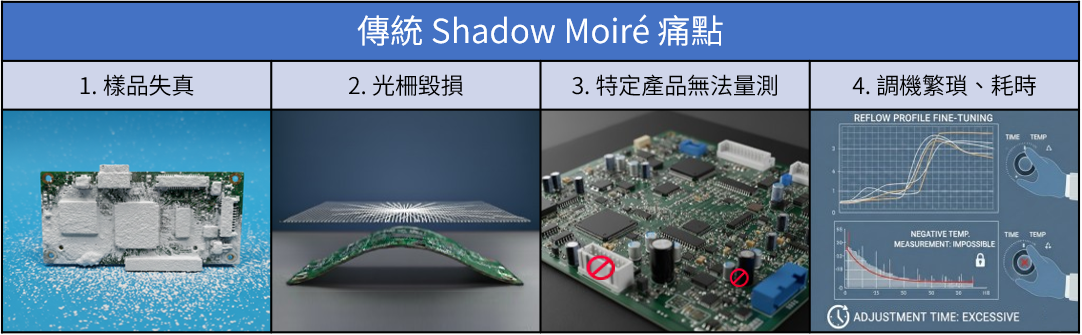
核心價值與技術優勢:
還在為迴流焊後的元件翹曲抓不到原因而煩惱嗎?
隨著產品價值提升,在極端熱應力下,微小翹曲都可能成為毀滅性的風險。
INSIDIX 採用「無光柵投影疊紋技術(Projection Moiré)」,徹底突破傳統Shadow Moiré繁瑣的樣品前處理限制。結合精密溫控 Chamber,可真實模擬迴流焊溫度曲線,即時量測產品的3D翹曲動態,將潛在的失效風險轉化為可控的量化數據,助您精準掌握產品穩定性。
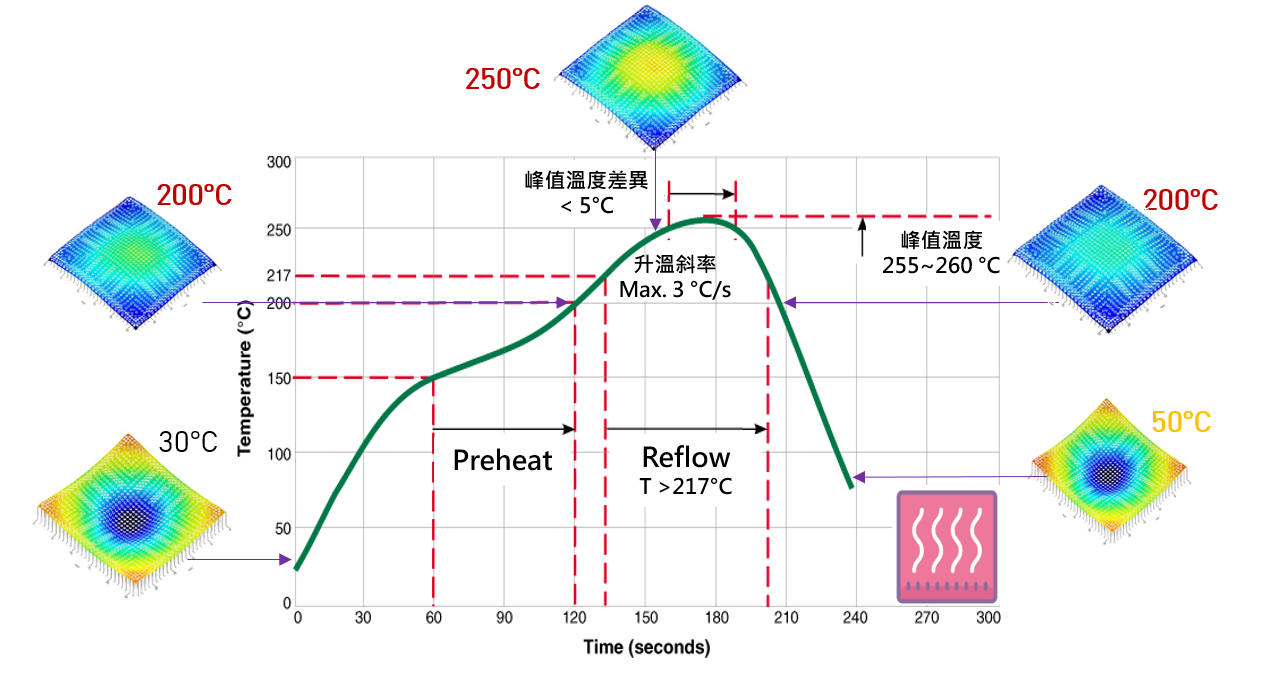

核心技術/優勢 |
技術亮點 |
客戶效益 |
獨家OCT模組 |
支援狹縫/透明/鏡面產品,滿足全方位應用需求 |
應用擴充:涵蓋更多元產品別,提升機台價值 |
非破壞量測 |
克服傳統Shadow Moiré限制 |
節省成本:省下處理時間,提升稼動率 |
真實環境模擬 |
搭載上/下多區加熱系統,精準模擬Reflow環境 |
預判良率:產品量產前的風險預測 |
無光柵設計 |
無需使用、清潔玻璃光柵,使保養更為簡單 |
維護成本低:無光柵破裂、定期汰換需求 |
25MP高解析度 |
配備 2500 萬畫素相機,捕捉微觀型變細節 |
精準數據:提供RD/QC最可靠的分析數據 |
多模組整合 |
一機整合Scanning/ Multi FOV/ DIC (CTE)模組 |
快速切換:無須額外硬體安裝、校正,可直接使用 |
☆TDM除提供標準Reflow溫度外,更跨越 -65 ~ 400°C 全域溫度範圍,賦予您的團隊完整的熱翹曲解決方案。
數據視覺化與軟體介面:
TDM設備不僅是硬體和技術的累積,更是客戶最強大的分析工具。
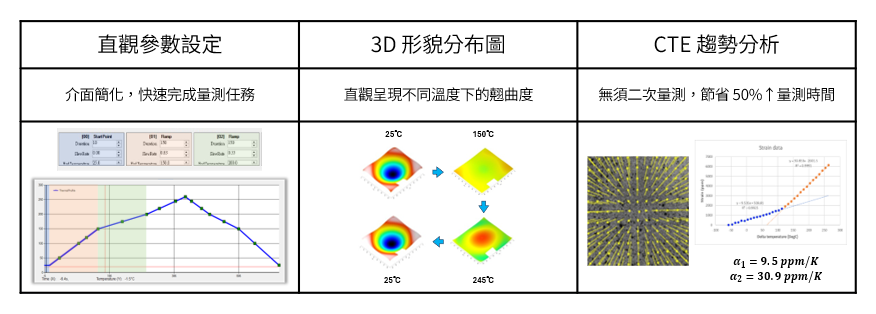
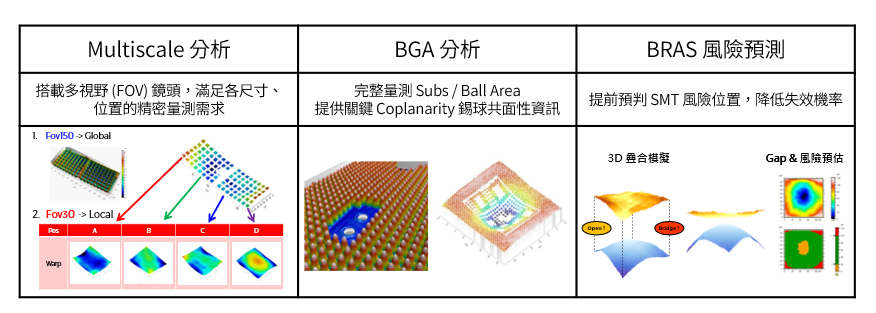
☆ 錫球共面性(Coplanarity)、熱膨脹係數(CTE)、BRAS風險預測;近年來成為客戶指名TDM設備的關鍵原因。
Application:全方位應用領域:
INSIDIX熱型變量測儀適用於各領域的產品,主要提供產品在不同溫度下的:熱型變翹曲度(Thermal Warpage)、熱膨脹係數(CTE)量測結果。
- 半導體製程:Die晶粒、Wafer晶圓、Panel面板。
- 先進封裝:BGA、Strip、SiP、CoW、2.5D/3D IC ...等。
- 電路板相關:CCL銅箔基板、PCB印刷電路板。
- EMS製程:Socket插座、Connector連接器、PCBA組裝電路板。
- 原材料、化學評估:Epoxy環氧樹脂、Film薄膜、Metal金屬。
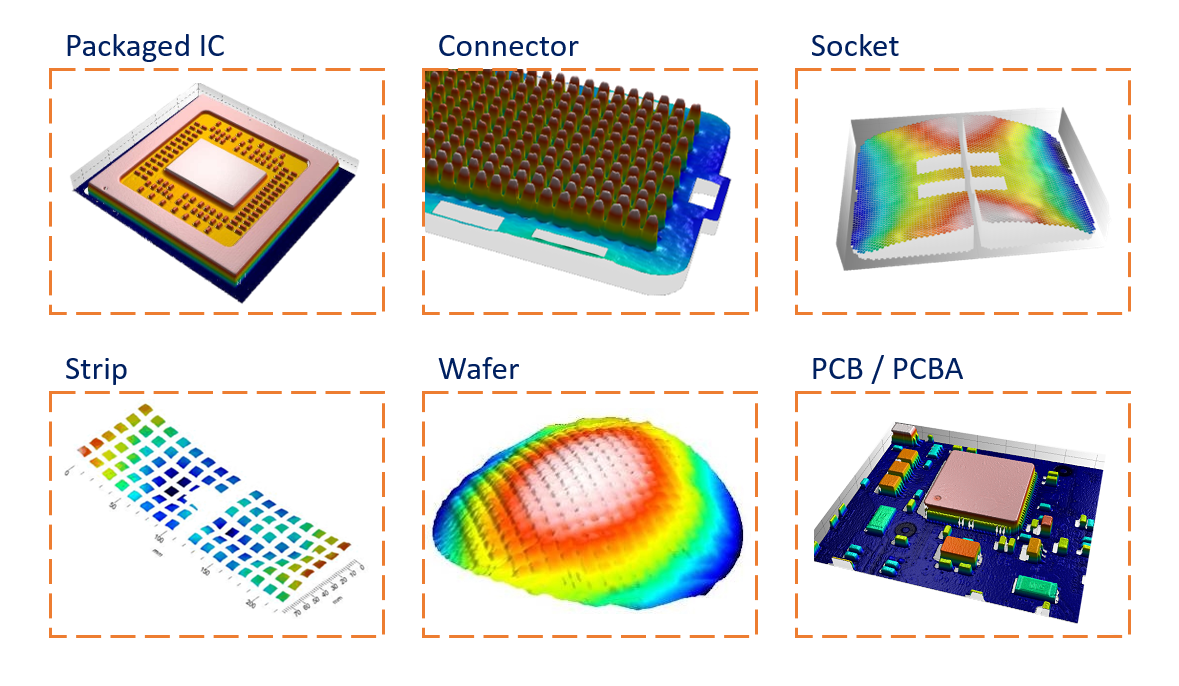
TDM系列規格對照表:
系列型號 |
溫度範圍 |
最大樣品尺寸 |
核心特色 |
TableTop |
-65 ~ 300°C |
200 x 200 mm |
桌上型:經濟高效,專為空間有限的實驗室設計 |
Compact 2 |
-65 ~ 300°C |
300 x 300 mm |
泛用型:適合中小型樣品,於設備體積與測試空間獲取平衡 |
Compact3 |
-65 ~ 400°C |
450 x 400 mm |
旗艦款:支持極端負溫,涵蓋絕大多數應用 |
Compact3XL |
RT ~ 300°C |
800 x 600 mm |
大尺寸首選:符合 伺服器/通訊 產業市場需求 |
讓勤友為您提供專業的解決方案
無論您需要溫度型變設備展示、評估測試,或特殊客製化,我們的團隊隨時準備為您服務。
☆ 「別讓溫度的波動,成為良率的漏洞 —— INSIDIX,捕捉每一微米的動態真相。」
若您對我司所代理之INSIDIX 溫度型變系統有興趣,歡迎來電或來信詢問
如您有特殊需求,也歡迎來信討論,我們將提供適合您的解決方案。

