
INSIDIX 温度型变系统

设备功能 :
INSIDIX使用投射迭纹法(Projection Moiré),将摩尔纹投射至被测物表面,透过Camera撷取被测物表面的条纹,进而计算产品3D翘曲度(Warpage)变化。此外,设备具备优异的Chamber能力,可仿真各式组件经过回流焊的温度条件,并于各温度点撷取产品当下的翘曲量,最终可提供用户完整的翘曲度变化信息。
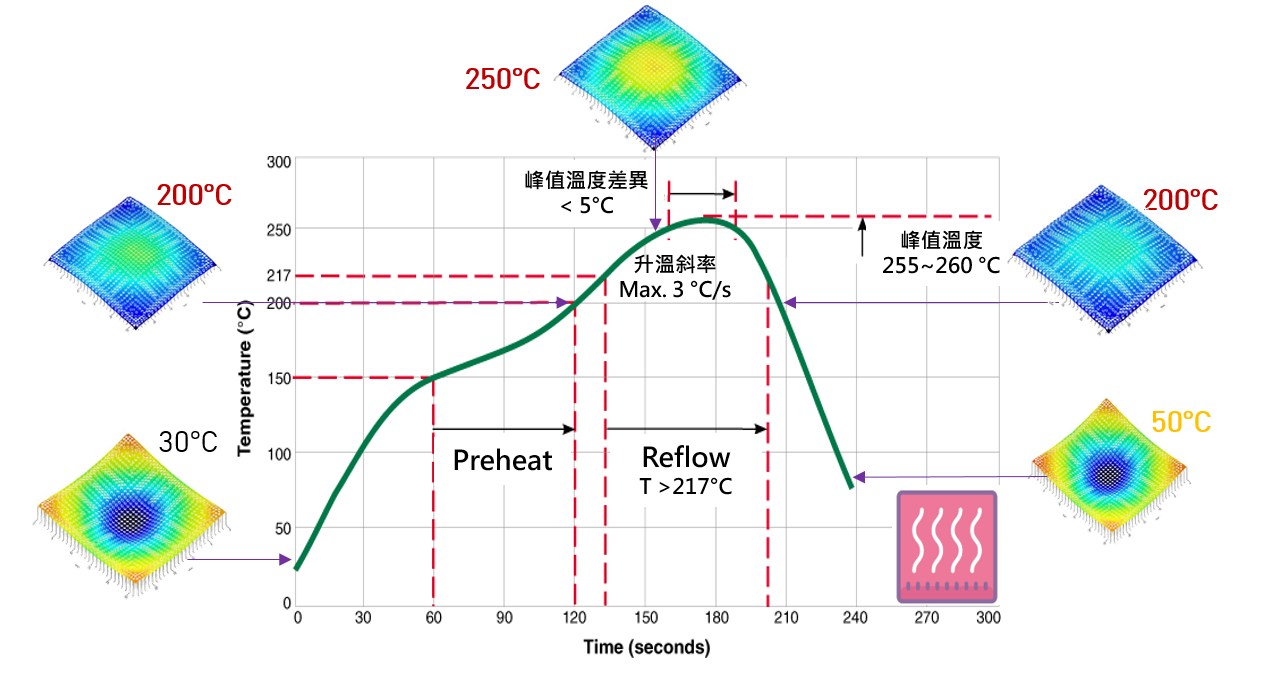

设备特点 :
- 优异的温度控制:Insidix搭载上、下方加热及冷却系统,提供卓越的升降温速率和热均匀性,协助模拟回流焊接的过程(Reflow Profile),确保测量结果更真实和准确。
- 高分辨率:12MP相机提供更高的XY分辨率,可精准计算细部的翘曲度变化,亦可进行材料的CTE量测分析。
- 保养简易:透由Projection Moiré技术生成摩尔纹。无需使用、清洁玻璃光栅,使保养更为简单。
- 稳定量测:量测过程无机构移动,确保量测数据更加稳定和可靠。
- 人性化软件界面:内建3D图像处理与报告制作之软件功能,大幅提升工作效益。
- 同步量测:除翘曲度量测(Warp)外,设备可同时进行热膨胀系数CTE量测,无须更换模块、二次测量,可大幅节省时间。
- 非连续面量测:可量测段差、PCBA、锡球…等不连续表面。
- XY Scanning Module:可对大尺寸wafer晶圆、Panel面板样品进行全面的扫描量测。
- Multiscale analysis:设备同时搭载不同FOV size的镜头,可随时对产品进行微观、巨观的量测,满足全方位量测需求。
- <最新>OCT Module:搭配最新OCT模块,无须喷漆即可完成透明、半透明、镜面产品量测,并支持12吋晶圆翘曲度量测。全方位的非破坏量测方案,大幅提升组件的再利用率。
应用:
Insidix热型变量测仪适用于各种产品,特别是泛电子、半导体等领域,用于测量产品在不同温度下所产生的热型变翘曲量(Thermal Warpage)、热膨胀系数(CTE)量测。这项技术可做为RD研发产品选用材料的参考,有助于缩短研发时间,加速产品上市,又或进行抽样检测,以确保提高SMT焊接时的良率。
应用领域:
- 各类封装IC的翘曲度量测,包括BGA、FlipChip、QFN、PoP...等
- 锡球共面性分析 (Solder balls coplanarity analysis,COP)
- PCB、Sockets、Connector、Stripe、Wafer晶圆、Panel面板
- 各式组件翘曲度量测(Warpage Measurement)、CTE量测(热膨胀系数,Coefficient of thermal expansion)
量测适用维度:涵盖 XS Die (芯片)、Wafer (晶圆),以及 Panel (面板);单次量测时间 < 2 sec
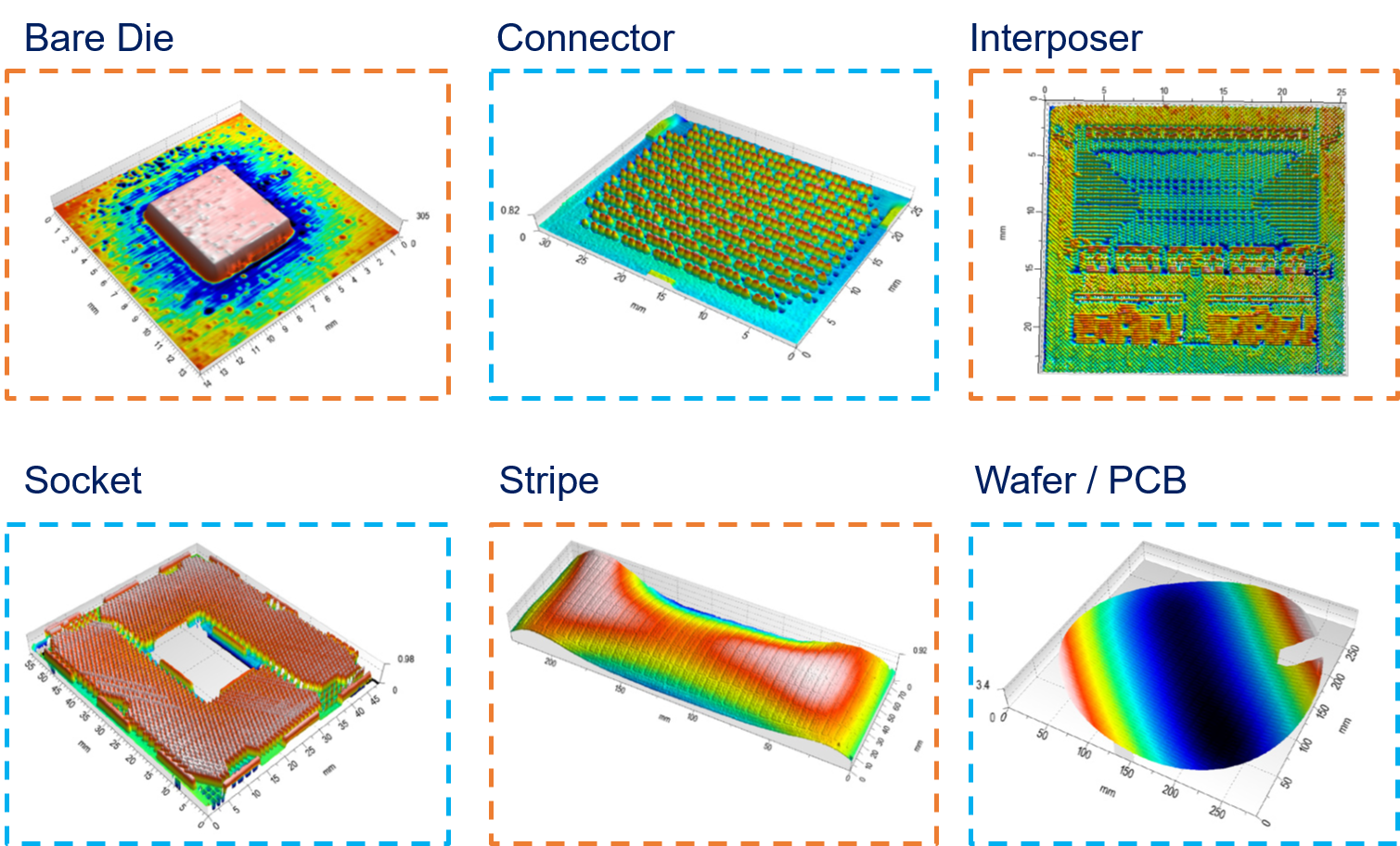
TDM系列规格比较:
| TDM TT | TDM Compact 3 | TDM Compact3 XL | ||
| 温度范围 | RT ~ 300 °C | -65 ~ 400 °C | RT ~ 300 °C | |
| FOV Size | Max. | 82 x 70 mm | 375 x 300 mm | 600 x 600 mm |
| Min. | 37 x 30 mm | 12 x 10 mm | 24 x 20 mm | |
| 翘曲度量测 | V | V | V | |
| 非连续面量测 (Ball coplanarity…等) |
V | V | V | |
| CTE量测 | V | V | V | |
| Multi FOV | X | V | V | |
| 支援负温量测 | V | V | X | |
若您对我司所代理之INSIDIX 温度型变系统有兴趣,欢迎来电或来信询问
如您有特殊需求,也欢迎来信讨论,我们将提供适合您的解决方案。

